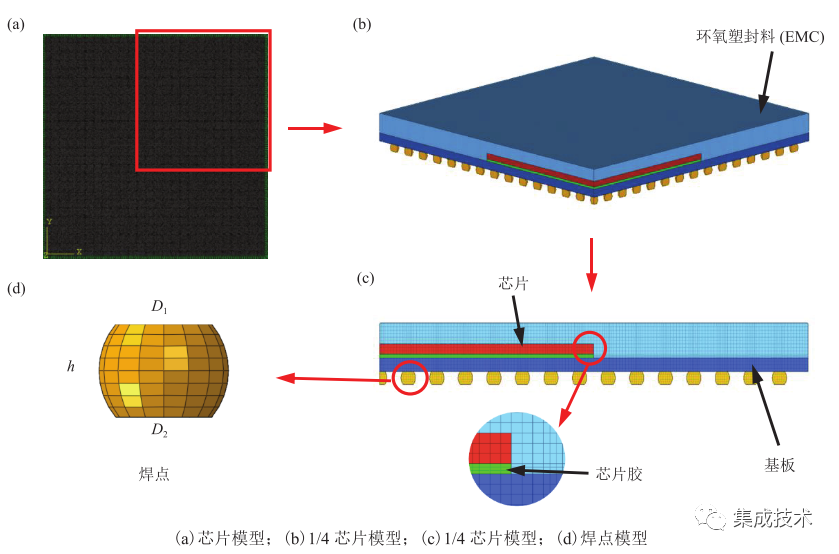
本文刊载于《集成技术》2021年第1期专题“深圳先进电子材料国际创新研究院专题”

摘要 Abstract
随着电子封装行业的迅猛发展,业界对封装结构可靠性的要求也越来越严格。目前大多数人将泊松比视为定值,这将在一定程度上影响可靠性评估。为了进一步提高可靠性,适当考虑材料泊松比对封装结构的影响具有重要的工程实践意义。该文利用有限元分析法,通过设计芯片仿真和板级封装仿真,分别探究了环氧塑封料泊松比对芯片翘曲、芯片界面应力以及板级封装焊点寿命的影响。通过分析可知:环氧塑封料泊松比可变对封装结构的翘曲具有较大的影响,而且有可能造成芯片界面分层、芯片达到应力极限而损坏,此外也需要适当考虑泊松比对焊点寿命的影响。随着芯片不断向着大尺寸方向发展,研究材料泊松比将具有更为重要的意义。
1 引 言
随着芯片技术不断地取得突破性进展,相同尺寸集成电路芯片上所集成的晶体管数目每隔 18 个月就会增加一倍,并且至少在接下来的十年中有望继续保持这种趋势。这就是著名的摩尔定律,它在过去几十年里被证实是正确的并且在不断地推动着数字电子、工业制造以及大数据人工智能等领域的发展。当今,飞速发展的半导体产业已成为技术和社会变革、生产力和经济增长的重要驱动力。随着芯片集成度的不断提高、多尺寸芯片的应用越来越广泛,业界对芯片可靠性的要求也在逐年上升。因此,进一步评估芯片可靠性并探讨深层次原因是至关重要的。
热翘曲行为是封装结构重要的热机械特性,其与球栅阵列(Ball Grid Array,BGA)封装结构的寿命息息相关。热翘曲主要是由封装结构各部分热膨胀系数(Coefficient of Thermal Expansion,CTE)不匹配而导致的,同时泊松比(Poisson’s Ratio)也可能对封装结构的翘曲造成很大的影响。泊松比是材料的基本属性,反映材料的横向变形能力,其变化将会影响材料力学性能的变化。Lee 等通过仿真证实了泊松比可变对翘曲量具有较大影响。Hassan 等指出泊松比对于准确预测芯片的可靠性至关重要。文献表明材料的泊松比具有较强的温度依赖性,一些高分子材料的泊松比变化往往十分显著。但在实际中,泊松比测试需要十分专业的设备(泊松比测试仪、DIC、静水压测试等),尤其是高温条件下的泊松比往往难以测试,且测试成本高昂。由于泊松比的测试十分复杂,故大多数人在研究中仍将泊松比视为常数,但这可能导致仿真结果存在较大的不准确性。此外,封装结构的焊点最容易发生疲劳失效,如微振动、电迁移、热翘曲等均会导致焊点开裂失效,并且焊点疲劳失效经常被作为封装结构可靠性的判据,因此研究可靠性时须研究焊点的疲劳寿命。
随着业界对封装结构寿命的要求越来越严格,有必要深入研究泊松比对封装结构可靠性的影响。本文研究了环氧塑封料(Epoxy Molding Compound,EMC)泊松比可变对芯片翘曲的影响,发现 EMC 泊松比变化会影响 EMC 的翘曲量。随着芯片尺寸的增加,泊松比对翘曲量的影响也会进一步增强。除了影响翘曲之外,泊松比也会改变芯片的界面应力分布以及封装结构焊点的疲劳寿命。因此,在特殊场景下,泊松比对可靠性的影响不容忽视,适当考虑材料泊松比对封装结构的影响具有重要的工程实践意义。
2 泊松比影响芯片热翘曲的仿真分析
由于芯片可靠性测试耗时长且成本高昂,因此有限元仿真被广泛用于分析芯片的可靠性。其中,有限元仿真能准确地预测电子封装结构的应力应变分布以及疲劳寿命,为可靠性分析提供精准的预测数据。目前,有限元仿真已成为预测封装结构可靠性的主要手段之一。
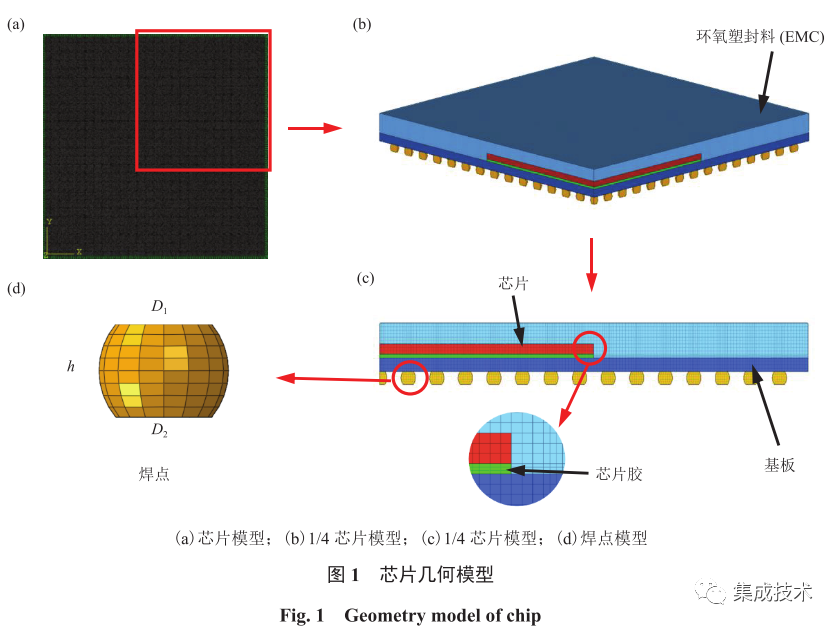
2.1 芯片有限元仿真
本文选用引线键合(Wire Bonding)芯片模型,来研究 EMC 泊松比可变对芯片可靠性的影响。为了减少运算时间,本文建立了 1/4 简化后的 BGA 封装模型(图 1),并使用大型有限元分析软件 ABAQUS 对模型进行求解。其中,有限元分析法(FEM)是一种为求解偏微分方程边值问题近似解的数值技术,而网格的质量和细化程度对结果会有所影响,因此本文使用 HYPERMESH16.4 进一步细化网格,获得了质量较高的六面体网格,并且网格与网格之间都能形 成共节点。芯片结构共包括 5 个部分:环氧塑封料(EMC)、芯片(Die)、芯片胶(Die Attach)、基板(Substrate)和焊点(Solder Ball),具体结构和材料参数如图 1 和表 1 所示。
本文采用 ABAQUS 隐式分析,仿真的边界条件设置为从 30 ℃ 到 125 ℃ 的加温,仿真中仅改变 EMC 的泊松比。通过参考文献的材料参数,本文将泊松比分别设为 0.25、0.35 和0.45,其他参数均不变。

2.2 泊松比对翘曲的影响
由于不同材料的热膨胀系数不匹配,芯片在升温过程将会发生翘曲。在长、宽尺寸为 20 mm 的 BGA 中,通过观察 EMC 泊松比为 0.25 时的翘曲云图(图 2(a))可知,EMC 的翘曲量从中心点到边角点逐渐增加,其中在 EMC 外边角点处翘曲量最大,为 59.61 μm。为了更直观地看出泊松比变化对翘曲量的影响,选取 EMC 外边角点,绘制出该点的翘曲变化曲线,具体如图 2(b)所示。经过分析可知,EMC 外边角点的翘曲量随着泊松比的增加而逐渐降低,翘曲量最多降低约 18 μm。这表明在此封装结构中,泊松比对翘曲已经有了较为明显的影响。翘曲过大将会降低芯片的可靠性,其中翘曲不仅会影响芯片的应力应变分布,而且还会影响回流焊过程中焊接不良的风险,故虽然不考虑泊松比可以简化仿真的复杂性,但在很大程度上会降低可靠性分析的准确性。

2.3 不同尺寸芯片的泊松比对翘曲的影响规律
在 2.2 小节的基础上,本节继续探究芯片尺寸不同时,EMC 泊松比对芯片的影响(其他参数不变),仿真参数设置如表 2 所示。

通过观察不同尺寸芯片在 EMC 外边角点处的翘曲量(图 3(a))可知:泊松比的增加会降低 EMC 的翘曲,而且芯片的尺寸越大,EMC 的翘曲降低量也越多,降低的速度也越快。为了能直观地看出尺寸与翘曲变化量的关系,本文绘制了尺寸与 EMC 外边角点翘曲变化量的曲线 (图 3(b))。其中,翘曲变化量(△Warpage)定义为泊松比为 0.25 时的 EMC 外边角点翘曲量与泊松比为 0.45 时的 EMC 外边角点翘曲量的差值。可以看出,芯片尺寸的增加能够大大增加 EMC 的翘曲,且芯片尺寸越大影响的程度也越大;当 EMC 长、宽尺寸为 10 mm 时,翘曲变化量约 2 μm;当 EMC 长、宽尺寸为 30 mm 时,翘曲变化量约 16 μm。因此,随着芯片尺寸的不断增加,泊松比对 EMC 翘曲的影响越来越显著,若不考虑泊松比将会降低可靠性分析的准确性。

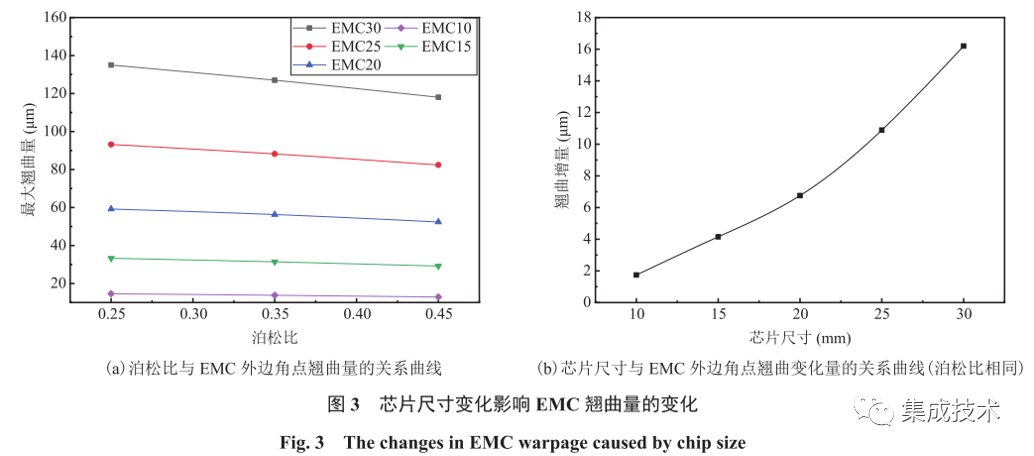
泊松比是材料的基本属性,其反映的是材料横向变形的弹性常数。泊松比测量方法一般是在拉伸或压缩实验时,材料的横向正应变与轴向正应变比值的绝对值,如公式(1)所示。在弹性范围内,材料的泊松比一般为常数,但部分高分子材料有时并不属于弹性材料,尤其是在温度发生变化时,其泊松比往往会发生变化。根据具广义胡克定律,泊松比变化会影响材料的体积模量和剪切模量(公式(2~3))。因此,EMC 泊松比变化使得体积模量、剪切模量亦发生改变,并会间接影响封装结构的翘曲以及应力应变。此外,芯片尺寸也能增加泊松比对翘曲的影响,这是因为翘曲能够在长度方向上不断积累。EMC 本身为高分子材料,其泊松比具有温度依赖性,在仿真中将泊松比视为常数会对可靠性产生较大的误差。由此可见,考虑泊松比对于进一步提高封装结构可靠性具有非常重要的意义。

其中,εx 为横向正应变;εy 为轴向正应变;E 为弹性模量。
3 泊松比对芯片界面应力的影响分析
界面应力过大往往会造成芯片界面开裂,甚至导致部分组件损坏。本节在第 2 小节的基础上,继续研究 EMC 泊松比对芯片界面应力的影响。如图 4(a、b)所示,通过观察 EMC 的应力云图可知 EMC 存在 2 个危险点:A 点为 EMC 内边角点,表现为基板对 EMC 的应力,该点应力过大将会导致 EMC 和基板的接触面发生开裂;B 点为芯片边角与 EMC 边角接触的点,表现为芯片对 EMC 产生的应力。根据图 4(c、d) 可知,EMC 泊松比的增加能增大危险点 A 的应力,z 方向的应力增大了 1 MPa(增幅约 25%), 等效应力增大了约 1 MPa(增幅约 10%)。EMC 翘曲本身是一种应力释放的过程,翘曲量减小反而可能导致应力不断积累。因此,泊松比增加导致翘曲量减小(图 3),进而导致 A 点应力增加。相反,芯片尺寸对 A 点的应力影响则较小,芯片尺寸的增加导致翘曲增加,这在一定程度上会释放 A 点的应力,导致芯片尺寸对 A 点应力的影响较小。由此可知,考虑泊松比能够进一步提高芯片界面应力分析的准确性,而芯片尺寸对界面应力的影响则较小。

根据芯片应力云图(图 5(a))可知,B 点为芯片应力最大值点,该点与 EMC 危险点处于同一位置,是容易发生疲劳失效的关键位置。如图 5(b、c)所示,EMC 泊松比从 0.25 增大至 0.45 时(尺寸不变),危险点 B 的等效应力增加约 6 MPa。这是因为当 EMC 泊松比增加时,芯片的翘曲会减少,导致芯片应力积累,进而 B 点应力增加。当芯片长、宽尺寸从 10 mm 增大至 30 mm(泊松比不变),危险点 B 的等效应力增加约 8 MPa。这主要是因为 B 点(芯片)被包围在 EMC 腔体之中,由于芯片尺寸增加而增大的影响(热膨胀)会全部作用在 EMC 的腔体中,应力无法释放,导致 B 点应力增加。因此,适当考虑泊松比能够进一步提高芯片应力分布的精确度,尤其是在大尺寸芯片中,泊松比可能是导致芯片失效的重要原因。
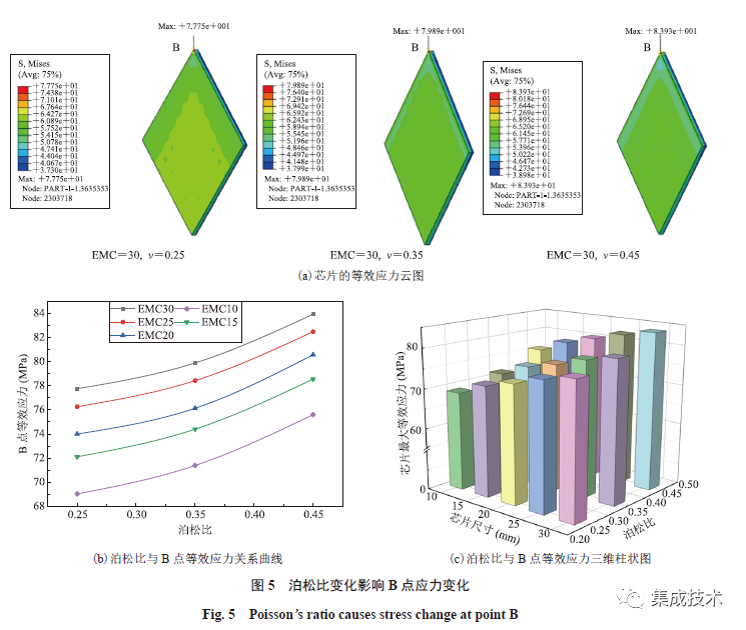
4 板极封装中泊松比影响焊点寿命的仿真分析
在板级封装结构中,焊点需要承受电负载和热应力(既要保证芯片和基板之间的电互通,还要起到组装 PCB 与芯片的作用),故焊点往往最容易出现疲劳失效。业界一般将焊点疲劳寿命作为封装结构可靠性的判据,因此需要重点考虑泊松比对焊点疲劳寿命的影响。

疲劳韧性系数可以采用线性温度相关性和对数频率相关性来描述,且需要同时考虑两种疲劳韧性参数的相关性,具体如公式(5~7)所示:

在板级封装结构的基础上,本节主要研究泊松比可变对焊点疲劳寿命的影响。板级封装结构是将芯片级封装结构组装在 PCB 板上,同样建立 1/4 封装结构,如图 6(b)所示。考虑到泊松比对大尺寸影响更显著,芯片选用长、宽尺寸为 30 mm 的芯片(表 2 中序号 10~12 组),设置不同 EMC 泊松比,分别为 0.25、0.35、0.45。PCB 板的杨氏模量为 26 GPa,泊松比为 0.30,CTE 为 16 ppm/℃;底部填充胶的杨氏模量为 6 500 MPa, 泊松比为 0.30,CTE 为 29.5 ppm/℃。Wang 等采用黏塑性本构模型(Unified Creep-plasticity Constitutive Model,UCP)来描述焊点的材料属 性,并估算了电子封装结构的热疲劳寿命。参照 Wang 等、Long 等的研究方法,本文焊点采用弹塑性本构模型,其余材料参数与上文所述一 致。温度循环边界采用 JESD22-A104C 标准,其中,温度循环加载如图 7 所示。
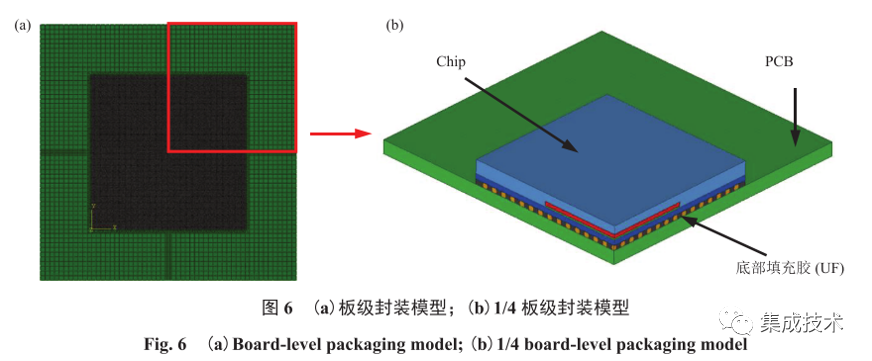

通过观察焊点的等效塑性应变云图(图 8(a))知:芯片对其下方的焊点影响十分显著,等效塑性应变最大点位于芯片边角下的焊点中,且该点最容易发生疲劳失效,其等效塑性应变约 0.002 136。通过选取板级封装仿真中最大等效塑性应变点,绘制了等效塑性应变随时间变化的曲线可知,EMC 泊松比增大将会增加焊点的等效塑性应变,如图 8(b)所示。将 3 种仿真结果的等效塑性应变代入公式(4)中可得:EMC 泊松比为0.25 时,Nf=90 582;EMC 泊松比为 0.45 时;Nf = 88 851。因此,泊松比增大会略微降低焊点的疲劳寿命, 影响芯片的可靠性。
需要注意的是,EMC 泊松比产生的影响是直接作用于基板和芯片上的,其对焊点寿命的影 响程度相对较小,但芯片中与焊点邻近部分的泊松比发生变化时(如基板、PCB 板以及底部填充胶(UF)等),将会大大影响焊点的疲劳寿命。本文也通过设置 EMC 泊松比不变(为 0.35)时,仅改变底部填充胶的泊松比,计算出对应疲劳寿命为:UF 泊松比为 0.20 时,Nf=393 400;UF 泊松比为 0.30 时,Nf =90 582;UF 泊松比为 0.40时;Nf=11 892。显然,UF 泊松比增加会大大降低焊点 的疲劳寿命,故不能忽视泊松比对焊点疲劳寿命的影响。因此,在预测焊点疲劳寿命时, 适当考虑材料泊松比具有十分重要的意义。

5 讨论与分析
目前,虽然大多数学者为了简化材料参数研究的计算时间,一般都会将材料泊松比视为常数,但是简化处理也会对结果精度产生一定的影响。Lee 等通过改变 EMC 泊松比(从 0.20 到 0.45),测得翘曲量变化约 25 μm。本文改变 EMC 泊松比(从 0.25 到 0.45),测得 EMC 最大翘曲量变化约 18 μm。因此,EMC 泊松比变化将影响芯片的翘曲量,这与 Lee 等的结论是相同的。同时,本文在研究 EMC 泊松比改变会增加芯片翘曲量的基础上,进一步探究了芯片尺寸增加能够增大 EMC 泊松比变化对翘曲的影响;并且 EMC 泊松比增加会造成芯片与基板接触界面应力增加(A 点应力最大增加了约 1 MPa,增 幅约 25%)、芯片与 EMC 接触点应力增加(B 点应力最大增加了 6 MPa),这可能造成芯片界面分层、芯片达到应力极限而损坏。此外,Hassan 等指出输入精准泊松比对精准预测芯片可靠性具有非常重要的意义,本文研究表明 EMC 泊松比会轻微降低焊点的疲劳寿命(焊点寿命降低了 3 200 多次循环,仅降低总寿命的 3%),但当芯片中与焊点邻近部分的泊松比发生变化时,材料泊松比在很大程度上会影响焊点的疲劳寿命(如 UF 材料泊松比变化后,寿命降低了 381 508 次循环,降低总寿命的 97%)。
6 总结
随着业界对可靠性的要求越来越严格,进一步评估泊松比对封装结构可靠性的影响并探讨深层次原因是至关重要的。本文利用有限元分析法,通过研究芯片仿真和板级封装仿真,分别探究了 EMC 泊松比对芯片翘曲、芯片应力分布以及板级封装焊点寿命的影响。通过分析可知:EMC 泊松比可变对翘曲具有较为明显的影响,而且这种影响会随着芯片尺寸的增加而增加;泊松比增加也有可能造成芯片界面分层、芯片达到应力极限而损坏;EMC 泊松比也会影响焊点的疲劳寿命,尤其是当芯片中与焊点邻近部分的泊松比发生变化时,在很大程度上会影响焊点的疲劳寿命。因此,为了提高封装结构可靠性的设计精度,需要考虑泊松比对封装结构的影响。随着芯片不断向着大尺寸方向发展,研究材料泊松比 对封装可靠性的影响具有更为深远的意义。
引用本文:李呈龙,钟诚,刘永超,郭蕊,鲁济豹,孙 蓉.环氧塑封料泊松比对球栅阵列封装可靠性的影响 [J].集成技术,2021,10(1):63-73




