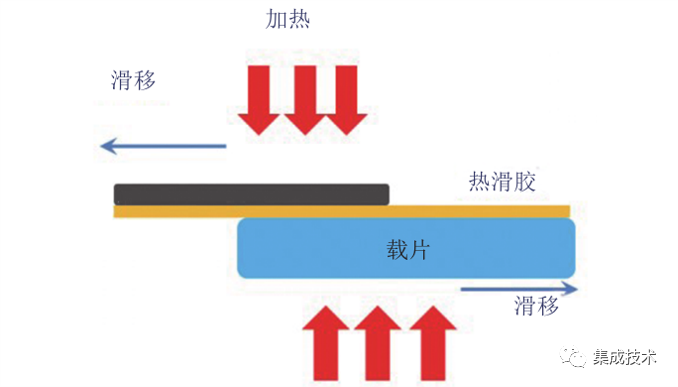
本文刊载于《集成技术》2021年第1期专题“深圳先进电子材料国际创新研究院专题”

摘要 Abstract
临时键合技术作为一项解决先进制造与封装的关键工艺,可为薄晶圆器件的加工提供一种高可靠性的解决方案。该文成功研发出热滑移解键合和紫外激光解键合两种不同解键合方式的临时键合材料。结果显示,与国外同类产品相比,热滑移临时键合材料 WLP TB130 和 WLP TB140 具有更高的耐热性,5% 的热失重温度均大于400 ℃,同时也具有更好的耐化性,其中 WLP TB140 可在 160 ℃ 实 现低温解键合。紫外激光解键合材料为 WLP TB4130 与 WLP LB210 配合使用(WLP TB4130 作为黏结层,WLP LB210 作为激光释放层),超薄器件晶圆键合对通过激光解键合方式实现室温、无应力地与支撑晶圆分离。
1 引 言
随着消费类电子产品的快速更新换代,5G通信 CPU/GPU 等高端芯片也朝着高频高速、多功能、高性能、小体积和高可靠性等方向发展。为了满足集成电路芯片微型化、多功能化和智能化的要求,摩尔定律的发展也受到物理极限的挑战,而封装技术在集成电路芯片制造中将起到助力摩尔定律持续发展的作用。因此,先进封装技术的发展主要集中到三维堆叠封装上,这样不仅减小了封装体积,而且提高了电路性能、减小了寄生效应和时间延迟。当前集成电路有两个重要特征,一是前道制造接近物理极限,摩尔定律发展趋缓;二是微电子产品的多元化,智能移动终端、物联网、人工智能、5G 通讯等百花齐放。为满足集成电路性能的多功能化及产品的多元化需求,推动了 3D-IC、系统级封装、异质集成等新技术的不断涌现。上述技术中,芯片或封装体的减薄和拿持技术愈发重要,但无一例外都面临着超薄圆片的拿持问题,因此临时键合技术 作为先进制造与封装的关键工艺受到越来越多的关注。其主要原因是因为:(1)随着先进封装中芯片尺寸的缩小,芯片晶圆越来越薄,容易出现卷曲甚至破片,因此在芯片制造流程中为了拿持超薄晶圆就必须采用临时键合技术将其临时黏接在厚载片上;(2)在扇出型(Fan Out)晶圆级封装中,重构的塑封料晶圆翘曲较大,不利于后续作业制程,需要临时键合技术来提高封装精度;(3)超薄器件的“增材制造”同样需要临时键合技术来支撑超薄器件层的半导体工艺制程;(4)III-V 族化合物半导体材质性脆,为了防止加工过程中出现破碎,同样离不开临时键合技术。
临时键合/解键合作为超薄晶圆减薄、拿持的核心技术,通过将器件晶圆固定在承载晶圆上,可为超薄器件晶圆提供足够的机械支撑,保证器件晶圆能够顺利安全地完成后续工艺制程, 如光刻、刻蚀、钝化、溅射、电镀和回流焊等。在先进封装制程快速发展的当下,临时键合/ 解键合技术已经得到大力发展并广泛运用到了晶圆级封装(WLP)领域,如 PoP 层叠封装、扇出型封装、eWLB、硅通孔(TSV)、2.5D/3D 封装等。而随着先进封装趋势向着更复杂的异质集成、更大的封装载体、更薄的芯片以及更小的封装尺寸等方向发展,临时键合技术的发展同 样也不断迭代,以满足封装技术飞速发展的需要。
自 2000 年至今,临时键合材料的发展已经迭代了四次,其主要区别在于各代的解键合方式不同,具体如表 1 所示。其中热滑移解键合和紫外激光解键合是最广泛使用的两种临时键合材料系统解决方案,二者各有优势。随着材料和工艺技术的不断进步,临时键合解决方案必将成为推动先进封装技术不断发展的重要组成部分。
美国 Brewer Science 公司在 20 世纪初就开始研发临时键合材料产品,其早期开发的热滑移解键合材料 WaferBond HT-10.10 和最新的紫外激光解键合材料 WaferBond 305 及 WaferBond 701占据国内主要市场,但其热滑移解键合材料 WaferBond HT-10.10 仍然存在耐化性差、耐热性不好和解键合温度较高等问题。
本文作者团队联合深圳市化讯半导体材料有限公司(以下简称“化讯半导体”)开展产学研协同攻关,成功开发出热滑移解键合和紫外激光解键合两种不同解键合方式的临时键合材料,解决了临时键合材料耐热性能和耐化学腐蚀性问题,同时成功通过多家行业龙头封装客户的工艺验证,实现规模化应用。需要说明的是,化讯半导体于 2020 年 6 月已在互联网“芯思想”上对与本文临时键合材料相关的产品进 行线上推广。

2 实 验
2.1 临时键合胶体系
本文实验涉及的临时键合材料及配套清洗剂类型包括热滑移临时键合材料(WLP TB130 或 WLP TB140)、紫外激光解键合材料(WLP LB210 和 WLP TB4130)和临时键合材料清洗剂 WLP TBR2。其中,以上材料均由深圳市化讯半导体材料有限公司提供。
2.2 方法及表征
临时键合材料通过旋涂仪(WS-650-8B,美国 Laurell 科技公司)分别旋涂于 8 寸晶圆上,随后通过热板(NDK-2K,日本亚速旺株式会社)分别进行固化。其中,临时键合材料烘烤工艺为:100 ℃,5 min;220 ℃,10 min。WLP LB210 烘烤工艺为:115 ℃,5 min;300 ℃,10 min。
涂覆临时键合材料的晶圆通过键合设备(SWB200/30L,上海微电子装备集团股份有限公 司)进行热压键合。其中,WLP TB130 键合条件 为:180 ℃,3 kN,保温 10 min;WLP TB140 键合条件为:130 ℃,2 kN,保温 10 min;WLP TB4130 和 WLP LB210 键合条件为:200 ℃,5 kN,保温 10 min。
热滑移晶圆对通过解键合设备(SWD100/10,上海微电子装备集团股份有限公司)进行解键合。其中,WLP TB130 解键合条件:190 ℃,160 N;WLP TB140 解键合条件:160 ℃,160 N。紫外激光键合晶圆对通过 355 nm 紫外激光设备。(DSI-SLLO660,大族激光科技股份有限公司)于 200 mJ/cm2技术 2021 年的能量密度下照射解键合
材料的热稳定性通过热重分析仪(Q600,美国 TA 仪器公司)进行测试。具体地,待临时键合材料挥发去除溶剂后,对固体材料进行测试——采用空气氛围,气流量为 100 mL/min, 起始温度为 30 ℃,终止温度为 800 ℃,升温速率 10 ℃/min,样品质量约为 10 mg。
材料的高温流变性能通过模块化智能型高级流变仪(MCR302,奥地利安东帕中国有限公司) 进行测试。具体地,待临时键合材料挥发去除溶剂后,对固体材料进行测试,温度从 250 ℃ 逐步降到 150 ℃,测试不同温度条件下的黏度。
硅片和玻璃键合对缺陷通过超声扫描显微镜(D9600,Sonoscan 公司)测试——其中采用 230 MHz 高频探头。
紫外透过率为采用紫外可见近红外分光光度计(UV-3600,岛津企业管理(中国)有限公司)测试样品在 200~400 nm 波段的结果。
3 结果与讨论
3.1 热滑移解键合
针对热滑移解键合系统,本文作者团队开发了临时键合材料 WLP TB130 和 WLP TB140,其解键合工艺如图 1 所示。

热滑移解键合临时键合材料包括 WLP TB130 和 WLP TB140 两种材料,适用于 4~8 inch 的微机电系统(MEMS)、化合物半导体晶圆的临时键合。两款材料(WLP TB130 和 WLP TB140)为同种结构的高分子聚合物,其化学稳定性、材料的耐热性相同,制程耐受温度均可达到 250 ℃,相应关键物性如表 2 所示。
3.1.1 高温流变性能及解键合温度
临时键合材料 WLP TB130 和 WLP TB140 为 热塑性聚合物,其作为临时黏合剂材料的主要原理是因其在加热时可以发生可逆软化。一般地,可逆软化性能可以通过材料熔体高温流变曲线来描述。其中,高温流变曲线是一种表征聚合物材料的高温黏度和温度之间关系的方法。图 2 所示为 WLP TB130、WLP TB140 和 HT-10.10 的黏度与温度的关系曲线。在 190 ℃ 时,HT-10.10 的黏度为 213 Pa·s,WLP TB130 的黏度为 255 Pa·s,二 者在此温度下黏度相当,故均可实现 190 ℃ 解键 合。在 160 ℃ 时,HT-10.10 的黏度为 491 Pa·s,WLP TB130 的黏度为 1 010 Pa·s,WLP TB140 的黏度为 172 Pa·s。由此可见,相对于 WLP TB130 和 HT-10.10,临时键合材料 WLP TB140 可以在较低的温度使器件晶圆与载体晶圆更容易解键合。
与 WLP TB140 相比,WLP TB130 在高温下具有更高的黏度,因此其键合温度和解键合温度会略高,但高温下尺寸稳定性较好,更适用于高温高精度加工工艺制程需求。而 WLP TB140 在高温下黏度较低,其中键合温度可低至 130 ℃、 解键合温度低至 160 ℃,更有助于产线的节能降耗和产能提高。

3.1.2 热稳定性能
临时键合材料作为一种半导体制程的过程材料,要求材料具有较高的热稳定性,能够使其在高温高真空制程,如在介质层固化工艺 (约 200 ℃)、回流焊(约 260 ℃)、PECVD(约150~200 ℃)等制程中,依然保持良好性能,不会因材料受热分解产生气体而产生“雪花状”缺陷,甚至键合对分层。而热失重曲线是一种表征聚合物材料失重比例和温度之间关系的方法。图 3 所示为 WLP TB130、WLP TB140 和 HT-10.10 热失重曲线。从图 3 可看出,WLP TB130 在 空气氛围质量损失 5% 时的温度大于 416 ℃, WLP TB140 在空气氛围质量损失 5% 时的温度大于 423 ℃,而在同等条件下,美国 Brewer Science 公司开发的 WaferBond HT-10.10 在 380 ℃ 的失重已经超过 5%。由此可见,与 HT-10.10相比,WLP TB130 和 WLP TB140 具有更好的耐热性能,能够满足半导体高温制程的要求。

3.1.3 耐化学腐蚀性能
在超薄晶圆加工制程中,临时键合材料需要在 不同温度下经历氧化剂、强酸、强碱及多种有机溶剂等湿制程,因此临时键合材料具有良好的化学稳定性显得至关重要。临时键合材料 WLP TB130 和 WLP TB140 是非极性聚合物,其具有优异的耐化学腐蚀性能。表 3 为临时键合材料 HT-10.10、 WLP TB130 和 WLP TB140 化学稳定性测试结果。从测试结果可以看出,在不同温度及药液测试条件下,WLP TB130 和 WLP TB140 键合对未出现分层腐蚀现象。由于 HT-10.10 不耐浓硫酸和浓盐酸,因此 WLP TB130 和 WLP TB140 具有更好的耐化学腐蚀性能。

3.2 紫外激光解键合
紫外激光解键合的临时键合材料系统由激光释放材料(WLP LB210)和临时键合材料(WLP TB4130) 两种材料组成。其中,WLP TB4130 主要起到黏结层作用;WLP LB210 作为激光响应层,可以吸收特定波长的特性使得其能吸收绝大部分紫外激光的能量,并将光子能量转化为化学键断键的能量,使得其分解失去黏性,并最终实现薄晶圆的高效、室温、低应力分离。相应临时键合工艺路线如图 4 所示。

该临时键合材料适用于诸如 Si interposer、eWLB、Fan-in、Fan-out、2.5D/3D 等行业领先的先进封装工艺平台,兼容 4~12 inch 多种基底与器件晶圆的临时键合。该材料关键物性如表 4 所示。

3.2.1 热稳定性能
WLP TB4130 和 WLP LB210 材料都具有较高的热稳定性,使其能够满足半导体超薄芯片制造的高温高真空制程。图 5 为 WLP TB4130 和 WLP LB210 的热失重曲线。从图 5 可以看出, WLP LB210 的热稳定性较高,在氮气氛围条件下质量损失 5% 的温度为 597 ℃,WLP TB4130 在空气氛围条件下质量损失 5% 时的温度为 424 ℃, 表明紫外激光解键合的临时键合材料具有良好的耐热性能。

3.2.2 化学稳定性能
临时键合材料 WLP TB4130 为非极性热塑性聚合物,其具有优异的耐化学腐蚀性能,而激光释放层材料 WLP LB210 为极性热固性聚合物,高温交联固化后具有优异的耐化学腐蚀性。表 5 为临时键合材料 WLP TB4130 和 WLP LB210 键合对化学稳定性测试结果。从表 5 可以看出,在不同温度及湿制程药液测试条件下,键合对未出现分层腐蚀现象。

3.2.3 紫外透过率分析
紫外激光解键合的临时键合材料系统在完成所有制程后,超薄器件晶圆通过紫外激光解键合方式实现室温、无应力地与支撑晶圆分离,因此紫外透过率具有很重要的作用。图 6 为临时键合材料 WLP TB4130 和 WLP LB210 紫外光透过率。从图 6 可以看出,当膜厚为 21 μm 时,WLP LB4130 在 355 nm 处的紫外透过率为 87%,对紫外激光吸收较低。当膜厚为 566 nm 时,WLP LB210 在 355 nm 处的紫外光透过率为 4.96%,表明激光释放层材料 WLP LB210 在 355 nm 时具有较高的紫外吸收率。
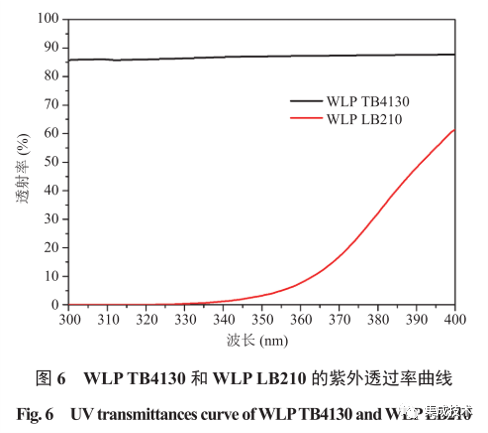
3.3 半导体制程表现
3.3.1 减薄及化学机械抛光验证
集成电路封装工艺前,需要对器件晶圆背面多余的基体材料去除一定的厚度进行减薄, 然后再进行化学机械抛光(Chemical Mechanical Polishing,CMP),得到超薄器件芯片。为了验证热滑移临时键合材料 WLP TB130 和 WLP TB140,以及紫外激光解键合临时键合材料 WLP TB4130 和 WLP LB210 在半导体减薄及CMP 制程中的表现,本文研究了硅晶圆和玻璃键合对的减薄及 CMP 工艺,结果如图 7 所示。键合对经过减薄及 CMP 工艺后硅片可减薄至 70 μm 左右,采用超声扫描显微镜检测结果显示,临时键合材料键合对表面形貌完整,无气泡、分层等缺陷。面多余的基体材料去除一定的厚度进行减薄,然后再进行化学机械抛光(Chemical Mechanical Polishing,CMP),得到超薄器件芯片。为了验证热滑移临时键合材料 WLP TB130 和 WLP TB140,以及紫外激光解键合临时键合材料 WLP TB4130 和 WLP LB210 在半导体减薄及 CMP 制程中的表现,本文研究了硅晶圆和玻璃键合对的减薄及 CMP 工艺,结果如图 7 所示。键合对经过减薄及 CMP 工艺后硅片可减薄至 70 μm 左右,采用超声扫描显微镜检测结果显示,临时键合材料键合对表面形貌完整,无气泡、分层等缺陷。
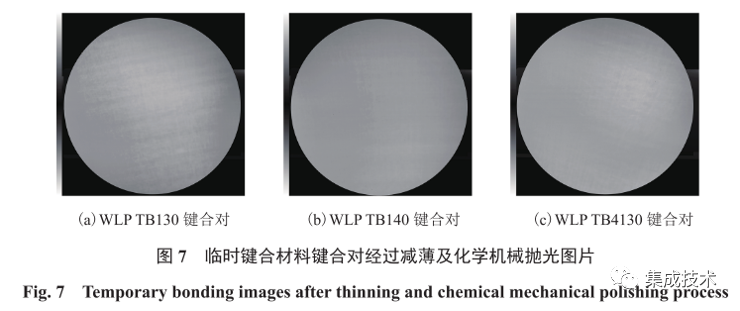
3.3.2 高温工艺验证
在临时键合材料使用过程中,超薄芯片需要经过绝缘钝化(200 ℃,120 min)、回流焊(265 ℃,10 min)等高温工艺制程。为验证临时键合材料 WLP TB130、WLP TB140、 WLP TB4130 和 WLP LB210 在高温制程中的表现,本文研究了硅晶圆和玻璃键合对在有氧烤箱中依次经过 250 ℃、2 h 烘烤,循环 4 次的性 能,结果如表 6 所示。经过高温工艺之后,键合对未出现分层、雪花气泡等缺陷,进一步证明所开发的临时键合材料具有优异的耐热性。
3.3.3 高温高真空工艺验证
在制造过程中,超薄芯片需要经过感应耦合等离子体蚀刻(ICP,150~200 ℃)、物理气相沉积(PVD,150~200 ℃)、等离子体增强化学的气相沉积(PECVD,150~200 ℃)等高温高真空工艺制程。为验证临时键合材料 WLP TB130、 WLP TB140、WLP TB4130 和 WLP LB210 耐高温高真空性能,本文研究了硅晶圆和玻璃键合对在 200 ℃ 真空烘箱、真空度约 20 Pa 条件下烘烤 1 h 的性能表现,结果如表 7 所示。经过高温高真空工艺之后,键合对未出现分层、雪花气泡等缺陷,进一步证明临时键合材料具有较高的耐热性。

3.3.4 解键合工艺验证
热滑移解键合临时键合材料 WLP TB130 或 WLP TB140 键合的超薄器件晶圆完成所有制程后,在一定温度下通过热滑移解键方式分离出来。其中,热滑移临时键合材料 WLP TB130 键合对实现 190 ℃ 解键合,WLP TB140 键合对实现 160 ℃ 解键合。因 WLP TB140 高温下黏度较低,故可以实现低温解键合。临时键合材料 WLP TB140 解键合结果如图 8 所示。

对于激光解键合临时键合材料 WLP TB4130和 WLP LB210 键合的超薄器件晶圆,在完成所有制程后,通过激光解键合方式可实现室温、无应力地与支撑晶圆分离。其中,利用 355 nm 紫外激光照射键合对后,键合对可轻易实现室温解键合,解键合结果如图 9 所示。

3.3.5 清洗工艺验证
超薄器件晶圆和载体解键合后,超薄器件晶圆表面残留的临时键合材料 WLP TB130、 WLP TB140 或 WLP TB4130 可通过配套清洗剂 WLP TBR2 采用旋涂方式或浸泡方式清洗。清洗前后通过 X 射线能谱(EDS)分析进行表征,结果如图 10 所示。能谱检测表明,在清洗前,晶圆上残留有 C 元素,而经过旋涂或浸泡清洗工艺后,表面无 C 元素残留,表明清洗过程快捷、效果良好。
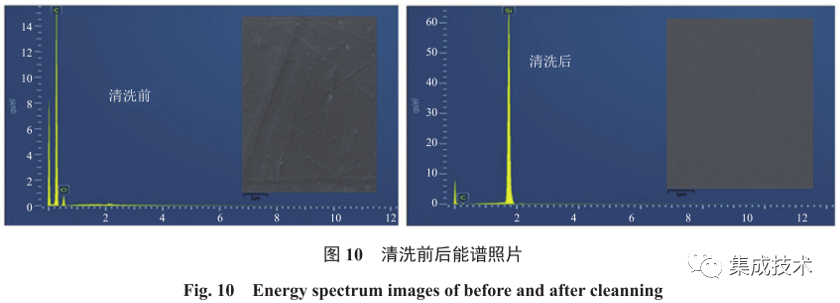
4 讨论与分析
本文通过现有分析方法,分别对国内外产品的耐热性、高温流变性能及耐化性进行了测试对比。测试结果表明,在耐热性方面,热滑移解键合材料 WLP TB130、WLP TB140 和国外对应临时键合材料 HT-10.10 相比具有明显优势。从热失重曲线来看,WLP TB130 和 WLP TB140 的 5% 热失重温度均大于 400 ℃,而 HT-10.10 在 380 ℃ 的失重已经超过 5%。
在高温流变性能方面,WLP TB140 在 160 ℃ 时的黏度为 172 Pa·s,比在 190 ℃ 时黏度为 213 Pa·s 的 HT-10.10 和黏度为 255 Pa·s 的 WLP TB130 黏度更低。这表明与 WLP TB130 和 HT-10.10 相比,临时键合材料 WLP TB140 可以在较低的温度使器件晶圆与载体晶圆更容易解键合。在耐化性方面,WLP TB130 和 WLP TB140 键合对在对应的制程溶剂中均未出现分层腐蚀现象,而 HT-10.10 不耐浓硫酸和浓盐酸。由此可见,WLP TB130 和 WLP TB140 耐化学腐蚀性能相对更具优势。
5 结论
根据解键合方式的不同,本文着重研究了两款应用最广泛的临时键合材料(热滑移解键合材料和紫外激光解键合材料)的工艺性能。结果显示,热滑移解键合临时键合材料适用于 4~8 inch 的 MEMS、化合物半导体晶圆的临时键合。两款材料 WLP TB130 和 WLP TB140 均拥有优异的化学稳定性和材料耐热性能,更低的键合温度有利于更有助于产线的节能降耗和产能提高。紫外激光解键合的临时键合材料系统可通过紫外激光解键合方式实现室温、无应力地与支撑晶圆分离。其中激光释放材料 WLP LB210 和临时键合材料 WLP TB4130 均具有优异的化学稳定性和耐热稳定性。该解决方案被广泛应用于 PoP 层叠封装、扇出型(Fan-out)封装、eWLB、硅通孔(TSV)、2.5D/3D 封装等先进封装制程。
引用本文:刘 强,夏建文,李绪军,孙德亮,黄明起,陈 伟,张国平,孙 蓉.面向超薄器件加工的临时键合材料解决方案 [J].集成技术,2021,10(1):23-34




